中國粉體網訊 碳化硅(SiC)作為重要的第三代半導體材料之一,在高溫、高頻、高功率、抗輻射等方面具有優秀的性能。SiC基器件已經在軍事、民事、航空航天等多領域得到了廣泛應用,是各國科學技術競爭的重點領域。SiC襯底晶片作為SiC產業鏈的基石有著至關重要的地位。

(圖源:天科合達)
然而,SiC的本身特性決定了其單晶生長難度較大。這主要是由于在常壓下沒有化學計量比為Si:C=1:1的液相存在,并不能采用目前半導體工業主流所采用的生長工藝較成熟的生長法——直拉法、降坩堝法等方法進行生長。為了克服這一難題,科學家們經過不懈努力提出了各種方法以獲得高結晶質量、大尺寸、廉價的SiC晶體。目前比較主流的方法有物理氣相傳輸法(PVT法)、液相法以及高溫氣相化學沉積法等。
PVT法
物理氣相傳輸法作為發展最早的SiC晶體生長方法,是目前生長SiC晶體最為主流的生長方法。該方法相較其它方法對生長設備要求低,生長過程簡單,可控性強,發展研究較為透徹,已經實現了產業化應用。
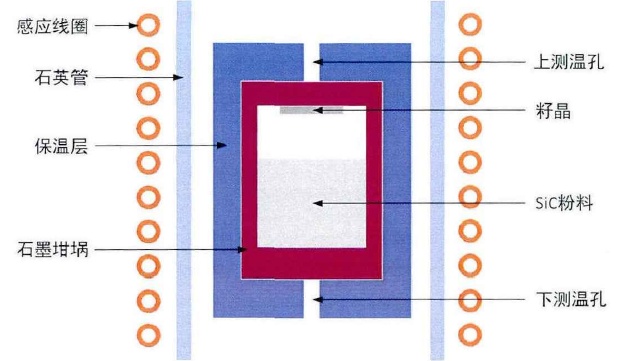
PVT法生長碳化硅單晶裝置示意圖
該方法是通過控制石墨坩堝外部保溫條件實現對軸向與徑向溫場的調控。將SiC粉料置于溫度較高的石墨坩堝底端,SiC籽晶固定在溫度較低的石墨坩堝頂。一般控制粉料與籽晶之間的距離為數十毫米以避免生長的單晶晶體與粉料接觸。溫度梯度通常在15-35℃/cm區間范圍內。爐內會保留50-5000 Pa壓強的惰性氣體以便增加對流。
在通過感應加熱的方法將SiC粉料加熱到2000-2500℃后,SiC粉料會升華分解為Si、Si2C、SiC2等氣相成分,隨著氣體對流被運輸到籽晶端,并在籽晶上結晶出SiC晶體,實現單晶生長。其典型的生長速率為0.1-2 mm/h。
經過數十年的不斷努力,目前PVT法生長SiC襯底晶片的市場已經十分巨大,每年SiC襯底晶片產量可達幾十萬片,其尺寸正逐步從4英寸換代到6英寸,并已經開發出了8英寸SiC襯底晶片樣品。
液相法
液相法生長SiC晶體由于更接近熱力學平衡條件,有望生長出質量更好的SiC晶體。液相法一般采用石墨坩堝,一方面是因為其耐高溫、抗腐蝕,另一方面是其可以為晶體生長提供C源。在石墨坩堝中放置硅原料以及一些摻雜物,由于坩堝壁處的溫度高,籽晶桿處的溫度低,石墨坩堝中的C溶解后就會在籽晶處和融化后的Si結合,形成碳化硅晶體。
相對于PVT法生長碳化硅,液相法具有位錯密度低、易于實現擴徑、可以獲得P型晶體等優點,但是在雜質含量控制、過渡元素選擇等方面仍存在一定問題。
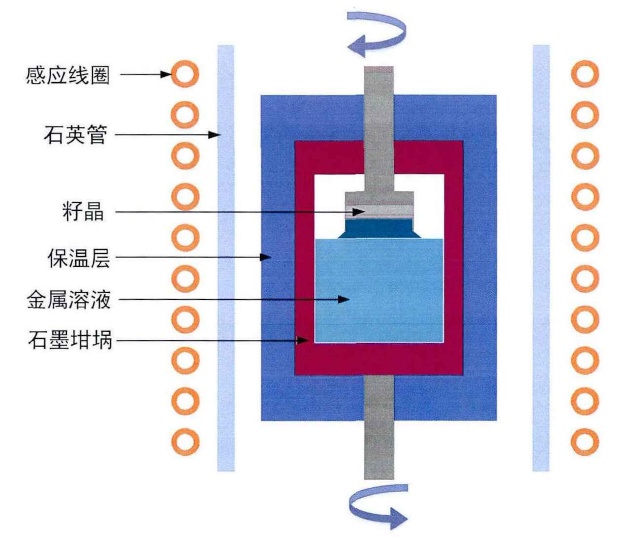
液相法生長碳化硅單晶裝置示意圖
近年來,日美等高校與公司開展了大量SiC晶體液相法生長的研究,名古屋大學、東京大學和豐田、新日鐵住金、LG等企業公司相繼投入了大量資金進行相關的技術產業研發,使得液相法生長SiC晶體技術不斷推進,受到更多的關注。
目前液相法已經成功實現了2英寸SiC單晶的生長,其生長晶體質量與PVT法生長的晶體質量相當。采用液相法4英寸SiC晶體的研究也在快速推進中。隨著液相法生長SiC晶體技術的不斷成熟,未來其對整個SiC行業的推進將表現出巨大潛力,很可能是SiC晶體生長的新突破點。
高溫化學氣相沉積法
HTCVD法生長SiC晶體和PVT法較為相似,反應容器為石墨坩堝,先驅體在坩堝底下氣體通道中進入石墨坩堝加熱區,在坩堝頂部裝有籽晶,氣體在溫度較低的籽晶處沉積生長碳化硅晶體。
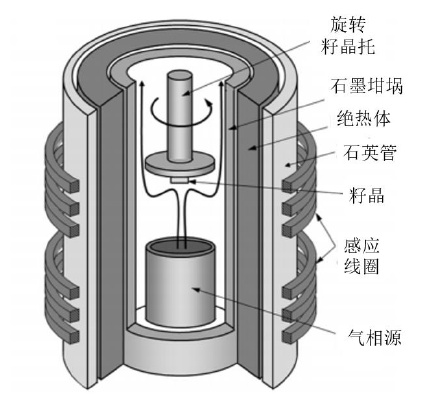
HTCVD法生長SiC晶體示意圖
高溫化學氣相沉積法反應的先驅氣體一般為硅烷(SiH4)和碳氫化合物,比如C2H4和C3H8等。HTCVD的反應溫度一般為2100~2300℃,在加熱區氣體會反應生成Si以及SiC,這些反應生成的氣體就是SiC晶錠生長的原料。氣體反應區的溫度要比籽晶處高,溫度梯度保證了質量傳輸,較低的溫度使得氣相在籽晶凝固。
HTCVD法作為一種采用氣相源供料的生長方法可以很好地控制生長過程中的氣相成分,保證原料供應充足,同時相比于一般的CVD法具有更高的生長速度,可達0.3-0.6 mm/h,可以滿足塊體SiC晶體生長需要。但是使用氣相原料大大提高了生長成本。相關研究的不充分也使得目前生長工藝尚不成熟,晶體缺陷較高。采用HTCVD法生長SiC晶體依然處于研發階段,在未來該方法有望成為一種大尺寸高質量SiC晶體的生長方法。
參考來源:
李鵬程:大尺寸碳化硅單晶生長設備及溫控方法研究,山東大學
張澤盛:液相法碳化硅晶體生長及其物性研究,中國科學院物理研究所
張浩:物理氣相傳輸法制備碳化硅晶體的工藝研究,哈爾濱工業大學
(中國粉體網編輯整理/平安)
注:圖片非商業用途,存在侵權告知刪除!